極紫外(Extreme Ultraviolet,EUV)光刻是以13.5nm為曝光光源的投影光刻技術,被公認為是最具潛力的下一代光刻技術。“極紫外光刻關鍵技術研究”作為一項前瞻性研究項目,旨在突破極紫外光刻研制中的國外技術封鎖。光電所承擔的“極紫外光刻原理實驗裝置機械與真空系統研制”課題為該項目的重要研究內容之一,主要解決曝光裝置高穩定真空環境、主動減振、自動輸片系統、高精度工件臺控制和納米級調平調焦測量系統等關鍵技術,是極紫外光刻曝光裝置集成和試驗必不可少的組成部分,該課題需研制的系統復雜、研制內容多、技術難度大。
光電所微電子裝備總體研究室團隊經過八年艱苦奮戰,突破真空、輸片、工件臺、減振和檢焦等關鍵單元技術:真空系統實現5.8×10-7Torr穩定的高真空環境,保證了EUV光源傳播的穩定性;整機框架及減振系統達到VC-F減振標準,水平方向2.2Hz-500Hz、垂直方向2Hz-500Hz頻率范圍隔振效果良好,框架、工件臺及掩模臺穩定性滿足32nm光刻需求和亞納米級波像差檢測;調平調焦檢測系統實現了納米級檢測精度,為32nm光刻分辨力的連續多次復現提供了保障。同時,工件臺研制中,在已有基礎上研究了多工件臺協同控制技術,解決了硅片臺與像方臺、掩模臺與物方臺的同時控制和位置切換問題;自動輸片系統實現真空環境中的全自動上下片;軟件系統完成多模塊復雜控制,協調各分系統完成曝光流程。
在完成關鍵單元系統研制的基礎上,配合項目總體單位長春光機所實現32nm可重復曝光以及配合上海光機所實現亞納米波像差檢測發揮了較大作用,受到項目總體單位、各課題單位及驗收組專家好評。在課題的研制過程中,課題組在工件臺控制、精密測量技術等領域取得了一系列原創性成果,累計申請發明專利31項,其中國內專利28項,國際專利3項。
課題順利通過驗收,表明光電所微電子裝備總體研究室團隊已經成為我國極紫外光刻研究隊伍的重要組成部分。同時,也表明我國現已突破EUV光刻設備研發的核心技術,為EUV光刻的下一步發展奠定了堅實的技術基礎。

裝置總體及關鍵單元系統
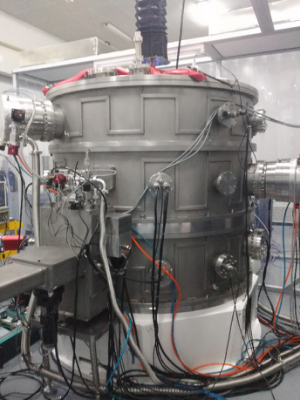
裝置實物
